(
映维网Nweon
2024年11月12日
)典型的薄膜镀膜技术是将具有高折射率和低折射率的两层或两层以上交替的材料结合在一起。为了设计的目的,希望两种材料的折射率有很大的差别。为了避免在宽入射角处具有较高的反射率,最上层的介电层具有较低的折射率是可取的。然而,沉积低折射率层是一项具有挑战性的任务,特别是考虑到与下面其他材料层的兼容性,或者当需要在顶部密封层以减少磨损效应、化学污染等时。
针对这个问题,Meta在一份专利申请中提出了一种在电介质堆栈之上沉积氟化镁多孔层的机制,其可以进一步降低折射率并减轻氟化镁产生的拉伸应力,从而允许形成更厚的层。在一个实施例中,缓冲二氧化硅(SiO2)层可设置在两个或多个块状或多孔氟化镁层之间,从而根据需要增大最顶层的厚度并对其折射率进行分级。
图2A-2C示出抗反射涂层200A和200B和反射率曲线210-1和210-2的横截面视图,其用于具有顶部折射率降低的介电层的抗反射介质堆栈。
在衬底212上形成涂层200。在这方面,衬底212可以包括弯曲形状,或凸或凹表面,或具有锐角的表面。另外,衬底212可以包括玻璃、塑料或任何其他用于制造光学元件的透明材料。
抗反射涂层200包括多层(ARC)堆栈214和顶部的低折射率层216。ARC堆叠214可以包括具有彼此相邻的不同折射率的交替材料层。在不受限制的情况下,ARC堆栈214中的交替材料层可以包括分别具有低/高RI(约1.46/2.39)的二氧化硅(SiO2)和五氧化二铌(Nb2O5)。另外,ARC 214中每个交替层的具体厚度可以根据涂层200的所需带宽和角性能单独选择。
层216可包括经过适当处理的氟化镁层。在一个实施例中,层216包括多孔氟化镁层,使得层216的折射率低于或显著低于氟化镁的RI (n=1.38)。

图2A示出抗反射涂层200A,其包括气孔205。在一个实施例中,顶层216的孔隙率随着靠近涂层200A的表面而升高,并且朝向与ARC堆栈214的边界而降低。这产生了一个增加RI的渐变指数效应,从而有利于涂层的带宽和角性能200。
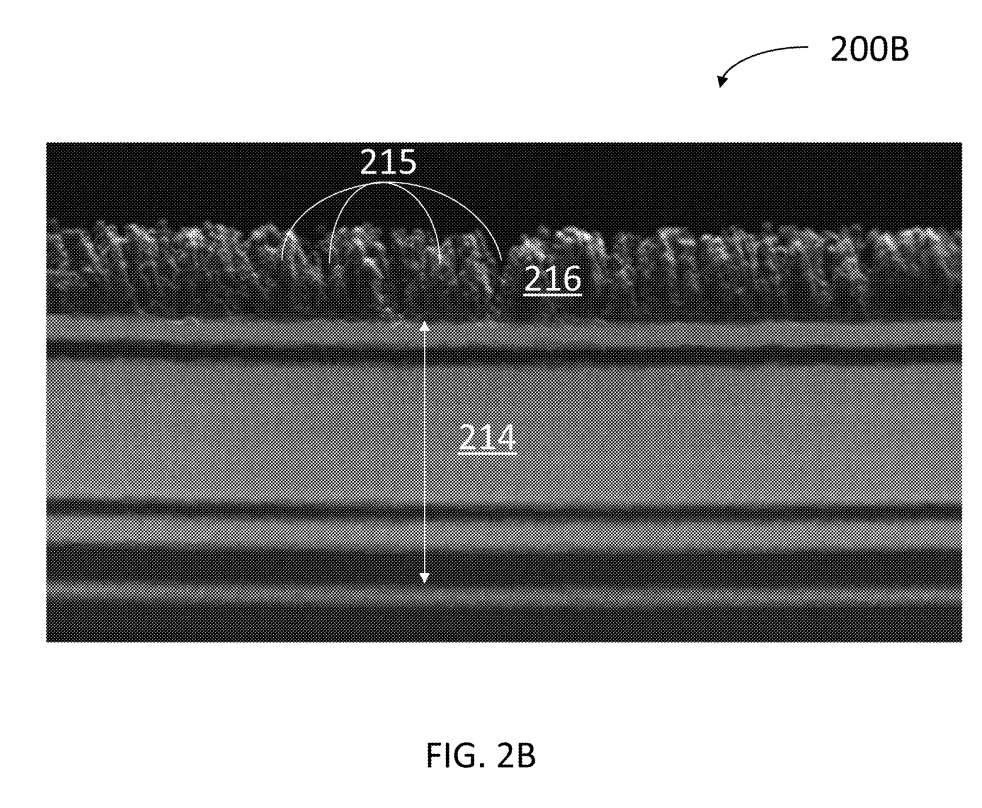
图2B是抗反射涂层200B的透射电子显微镜(TEM)图像,显示了在层216之上形成的多个孔隙215。层216的孔隙率使得层216的RI低于用于形成它的介电材料(例如氟化镁)的RI。

图2C示出抗反射涂层200的反射率曲线210。当使用块状氟化镁层210-1代替多孔氟化镁层210-2(例如顶层216)时,反射率曲线200表示反射率百分比(纵坐标202)作为波长λ(横坐标201)的函数。如图所示,多孔氟化镁层216将抗反射涂层200的反射率降低到1%以下(λ在约450 nm至约750 nm之间)。
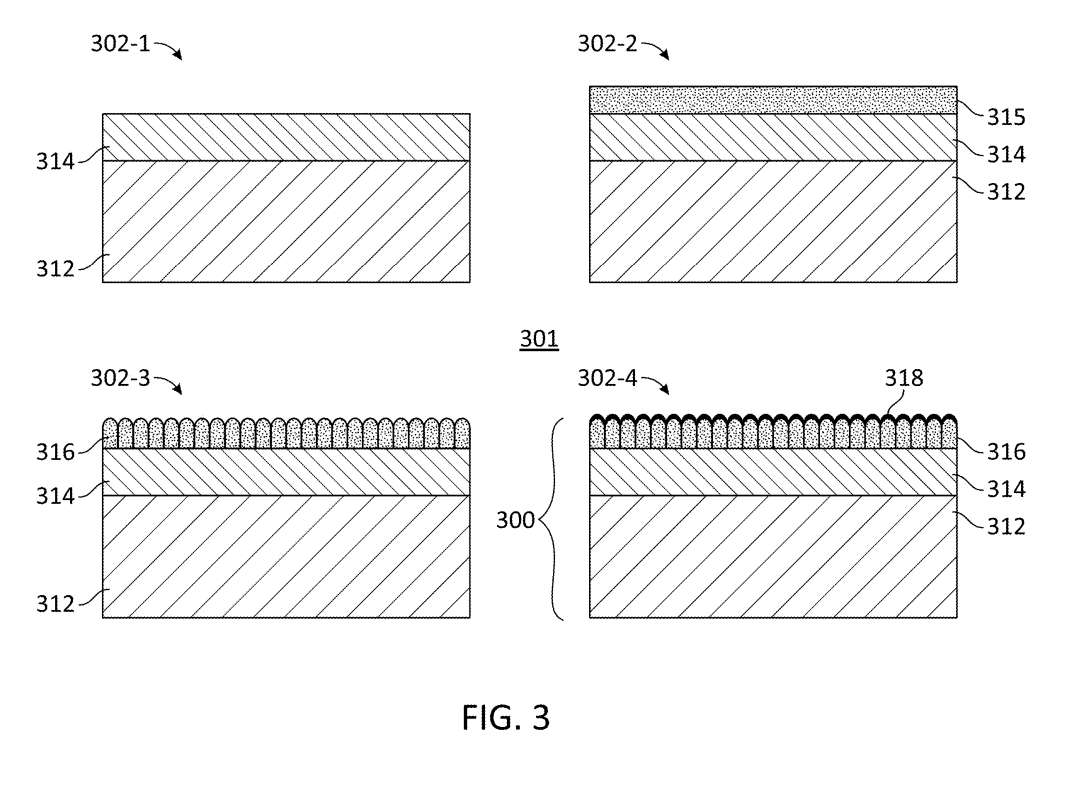
图3示出用于制造在顶层316处具有降低折射率的多层电介质堆栈300的工艺301,包括阶段302-1、302-2、302-3和302-4。工艺301中的材料沉积可以包括任何材料沉积技术。
在阶段302-1中,在衬底层312之上形成ARC堆栈314。ARC堆叠314包括具有交替折射率(例如,高/低)的介电材料的多层堆叠。
在阶段302-2中,所选材料的层315沉积在ARC堆栈314附近。层315中的材料是氟化镁或任何其他低RI介电材料。
在阶段302-3中,来自阶段302-2的315层蚀刻形成多孔层316,与315层相比,其折射率降低。在一个实施例中,阶段302-3包括将包含层315的结构浸入热去离子化(DI)水中。水浴的温度可高达沸点(例如,接近或等于100°c)。
在阶段302-4中,密封材料(例如氧化铝Al2O3)以保形沉积在顶层316,从而形成密封层318。在一个实施例中,密封胶层318的厚度可以是几纳米(nm, 1nm =10 – 9 m),例如5nm,或类似。密封胶层318防止了多孔层316的化学降解,并且对多层介电层300的光学性能几乎没有影响。
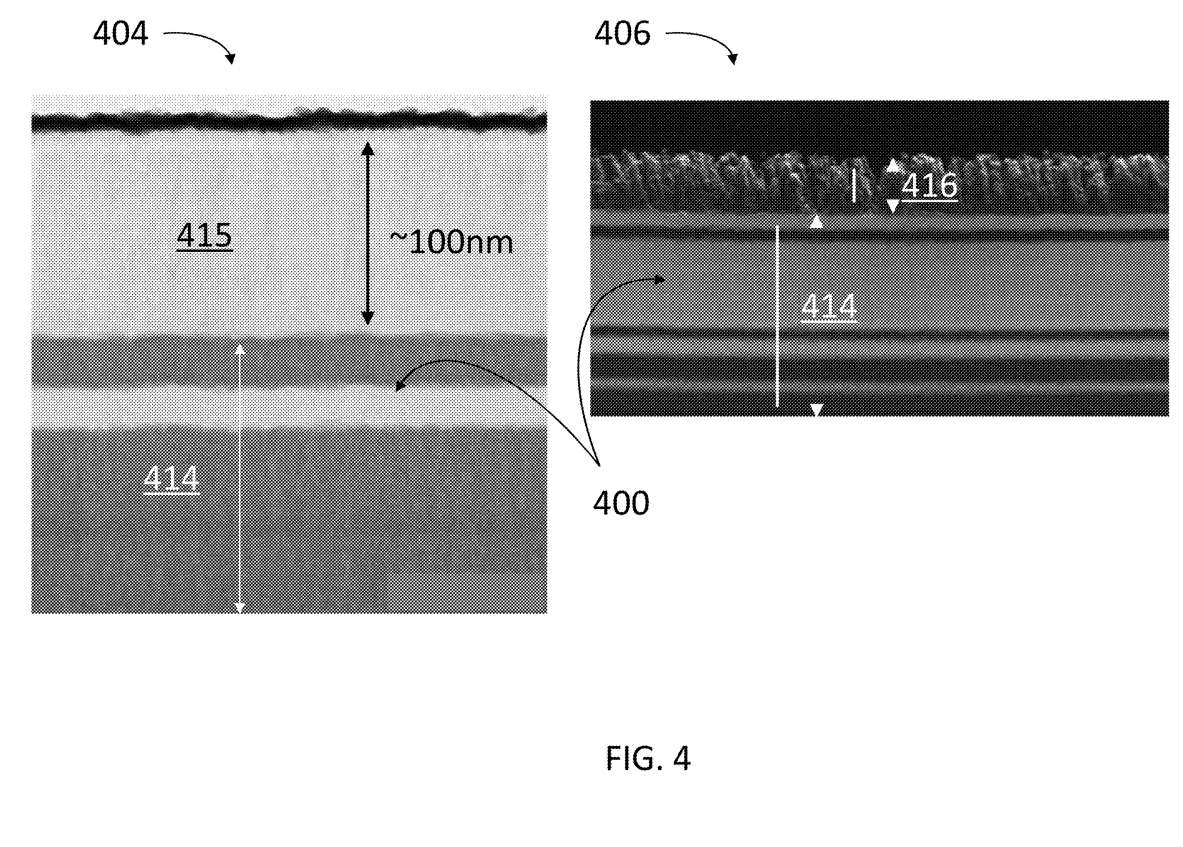
图4示出,在ARC堆栈414顶部的顶层415处折射率降低406之前和之后的电介质堆栈400的横截面视图。将顶层415置于蚀刻阶段(参见阶段302-3)后,在电介质堆叠400中出现多孔层416。通过蚀刻阶段产生层415中的实质性厚度减少。

图5示出用于制造具有降低折射率层516的多层介电堆栈500的工艺501,包括阶段502-1、502-2、502-3和502-4。在以恶搞实施例中,希望控制堆栈500中顶部介电层的厚度以获得更好的角度和宽带性能,并增强堆栈500的坚固性。
在阶段502-1中,在衬底层512之上形成ARC堆栈514。在以恶搞实施例中,ARC堆叠514包括具有交替折射率的介电材料的多层堆叠。
在阶段502-2中,沉积一个防蚀层517,将低折射率材料(例如氟化镁)的两层515-1和515-2分开。在一个实施例中,防蚀层517包括二氧化硅(SiO2)。在一个实施例中,防蚀层517可以是几纳米厚(例如,5-10纳米等)。防蚀层517的作用是防止515-1层在502-3阶段被DI水腐蚀,从而延长顶层515的整体厚度。当厚度小于或约为10nm时,防蚀层517的光学效应在可见光域中可以忽略不计。
因此,蚀刻阶段502-3包括用沸点或接近沸点的去离子水蚀刻层515-1,以形成多孔层516。
阶段502-4可包括用密封胶层518覆盖多孔层516。因此,多层介电堆500的顶层包括渐变折射率,而折射率在515-1、517和516层的组合厚度上从块状材料(例如氟化镁,n=1.38)的折射率缓慢下降到516层多孔材料(n<1.38)的折射率。
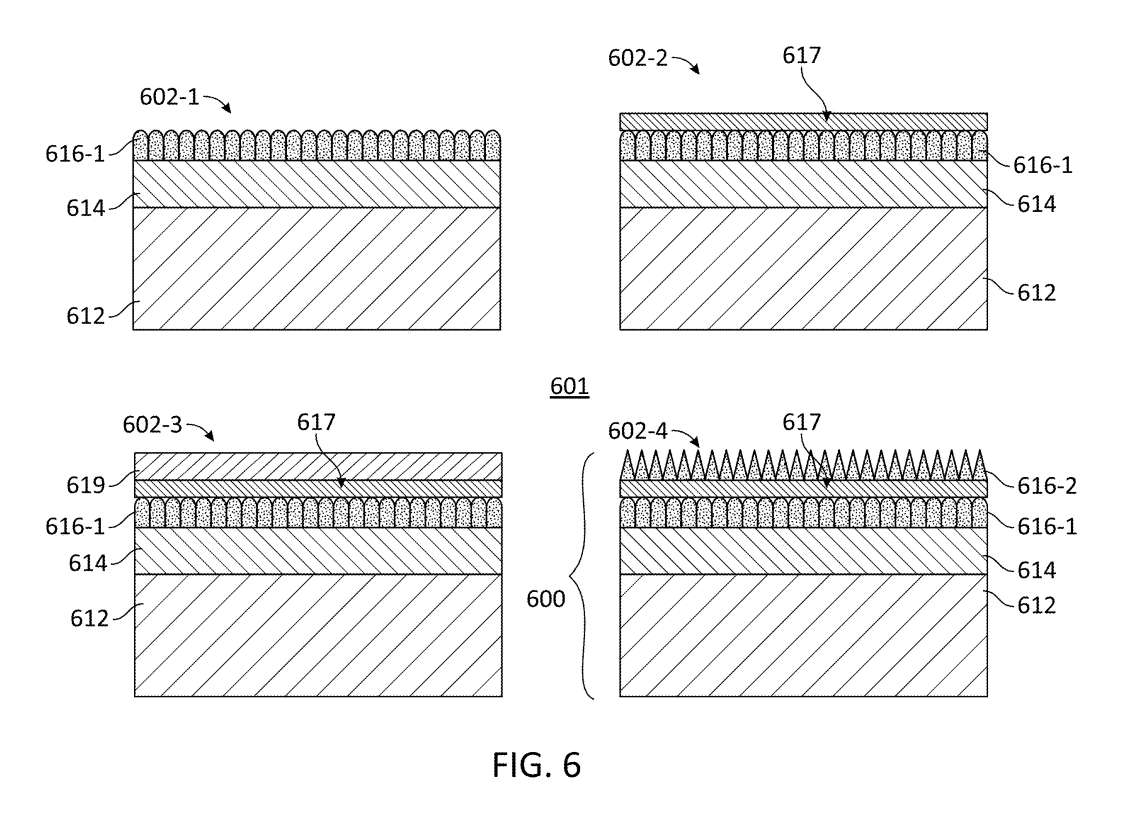
图6示出用于制造顶部具有不同折射率层的多层介电堆栈600的工艺601,包括阶段602-1、602-2、602-3和602-4。工艺601提供对顶部多孔层616-1和612-2的填充密度和厚度的控制。层叠600的渐变折射率通过改善其角度性能和宽带性能来增强其抗反射性能。
在阶段602-1中,衬底612、ARC堆栈614和第一多孔层616(例如多孔层)的设置如图所示。
在阶段602-2中,在第一多孔层616-1附近设置防蚀层617。
在第602-3阶段,在防蚀层617附近添加一层新的块状低折射率材料(例如氟化镁)。
在阶段602-4中,蚀刻层619以形成第二多孔层616-2,通过防蚀层617将其与第一多孔层616-1分开。防蚀层617防止在蚀刻阶段602-3期间改变第一多孔层616-1。因此,通过选择性地选择不同的参数来蚀刻第一多孔层616-1和第二多孔层616-2,可以通过堆栈600提供渐变折射率。

图7示出,在顶部具有降低折射率层716的抗反射层堆栈700的截面图701A、701B和701C。

图8示出抗反射多层电介质堆栈的横截面的组成图800。横坐标801 (x轴)表示深度(nm),纵坐标802 (y轴)表示成分百分比。
曲线810-5和810-6表明,在离堆表面约120 nm处氟化镁concentration缓慢增加。这表明了孔隙度,所以如预期的那样,堆栈中顶层816的RI较低。ARC堆栈814由所涉及的不同元素的交替组成表示。ARC堆栈814是由二氧化硅(SiO2,低RI ~ 1.46)和五氧化二铌(Nb2O5,高RI ~ 2.39)交替层组成。
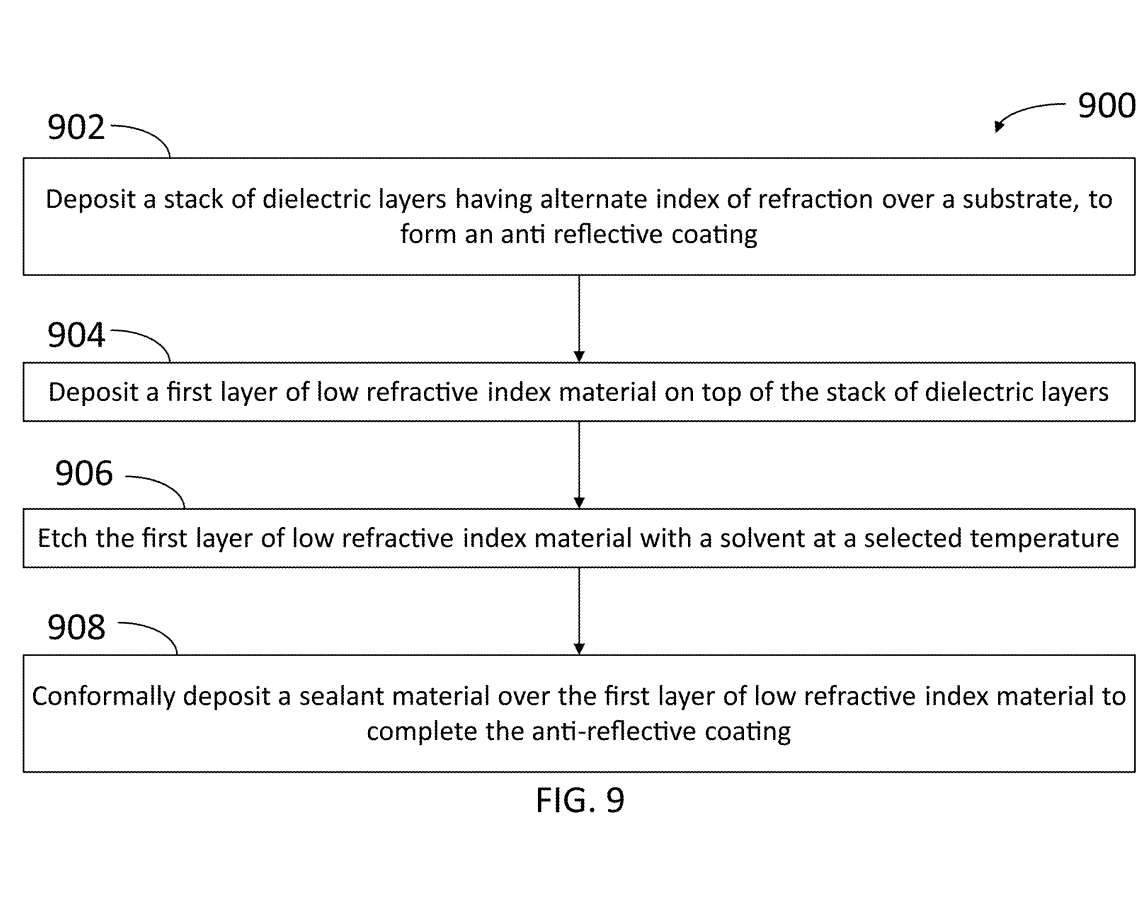
图9示出的流程图是形成用于光学表面抗反射涂层的低折射率介电层。
在902,在衬底上沉积具有交替折射率的介电层堆栈,以形成抗反射涂层。在一个实施例中,步骤902包括在根据第一层低折射率材料的选定晶粒尺寸选择的预选氩气压力下蒸发沉积低折射率材料在介电层堆叠上。在一个实施例中,步骤902包括用激光退火低折射率材料以控制第一层低折射率材料的晶粒尺寸。
在904,在介电层堆叠的顶部沉积低折射率材料的第一层。在一个实施例中,步骤904包括在第一层低折射率材料内沉积二氧化硅的防蚀层,并在二氧化硅的防蚀层上沉积第二层低折射率材料。
在906,在选定温度下用溶剂蚀刻低折射率材料的第一层或第二层。在一个实施例中,步骤906包括在所选温度下将具有介电层堆叠和第一层低折射率材料的衬底浸入溶剂中。在一个实施例中,步骤906包括将具有介电层堆叠和第一层低折射率材料的衬底浸入约沸点的水中一段选定的时间。
在一个实施例中,步骤906包括在存在或不存在超声波激励的情况下改变沸点以下的水温。在一个实施例中,步骤906包括在所选温度下将具有介电层堆叠和第一层低折射率材料的衬底浸入在所述溶剂中。在一个实施例中,步骤906包括在第一层低折射率材料上沉积二氧化硅的防蚀层,并在二氧化硅的防蚀层上沉积第二层低折射率材料。
在一个实施例中,步骤906包括在第一层低折射率材料上沉积一层硅的防蚀层,并在蚀刻第一层低折射率材料之前在第一层硅的防蚀层之上沉积一层低折射率材料。
在一个实施例中,步骤906包括在低折射率材料的多孔层上沉积一层二氧化硅的防蚀层,在二氧化硅的防蚀层之上沉积一层第二层低折射率材料,并在选定的温度下用溶剂刻蚀第二层低折射率材料,以进一步降低抗反射涂层顶层的折射率。
在908,在低折射率材料的第一层上共形沉积密封材料以完成抗反射涂层。
相关专利
:
Meta Patent | Fabrication of dielectric layers with varying refractive index for anti-reflection coatings
名为“Fabrication of dielectric layers with varying refractive index for anti-reflection coatings”的Meta专利申请最初在2023年4月提交,并在日前由美国专利商标局公布。
